|
|
 |

半導体製造に於ける工程について
半導体製造に使用されるシリコン基盤は数多くの工程を経て製造されますが主にシリコン基盤に回路を作り込む前工程(フロントエンド工程)
及びその後の実装工程(バックエンド工程)までを含む工程を後工程として区別しています。
これは要求される製造装置の性能及び製造環境のクリーン度が違っているためです。
テイコクテーピングシステム(株)は弊社の技術的な強みであるところの画像処理装置やACサーボモーター、ワンボードコンピューター等を応用した知能ロボットを応用した製品を数多く開発して装置の知能化、小型化、高度化に多大なる貢献をしています。
また半導体製造工程の高度化、工程の自動化、プロセス及びレシピのコンピューター化を通じてそのどちらの工程にも多くの装置を供給しています。
特に携帯電話に代表される 携帯端末装置、ICカード(スイカ、ETCカード、ICチップ埋め込み型クレジットカード等)の電子デバイスの軽薄短小化のために開発されたDF(ドライフィルム)DFR(ドライフィルムレジスト)の貼り付け装置、剥がし装置においていち早く対応装置を開発して現在多くの市場占有率を持っています。
本HPに於いては半導体製品の製造工程とテイコクテーピングシステム(株)の製品がどのように関わっているのかを集積回路の製造工程をたどっていきながら解説して参ります。
1: 材料としてのシリコンウエハーはまずインゴットとして生産されます。
 昔は火打ち石に使われていた「けい石」。そこにたくさん含まれているケイ素を取り出して、作られるのが金属ケイ素。 昔は火打ち石に使われていた「けい石」。そこにたくさん含まれているケイ素を取り出して、作られるのが金属ケイ素。金属ケイ素から、99.99999999%という高純度のケイ素の塊、多結晶シリコンが作られます。 この多結晶シリコンを原料に、結晶成長技術を駆使して一定の分子配列を持った直径約30センチ(12インチ)、長さ約1mという大きなシリコンの結晶(単結晶)を作ることができます。この単結晶の塊(インゴット)を、薄くスライスして作られるのがシリコン・ウエハー。エレクトロニクス製品に欠かせない半導体デバイス。その基板となっているのが単結晶シリコンのウエハーです。 テイコクテーピングシステム(株)は、単結晶シリコンのインゴットおよびウエハーの生産における紫外線照射技術を利用した自動化装置を通じて、シリコン・ウエハー大口径化及び高品質化に貢献しています。 |
ウエハー表面の鏡面化にUVテープが使用されます。
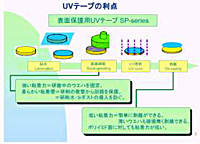 古川電工関連ページへ ウエハーの切り出し後 UV 硬化型両面テープを使用して 表面研削 エッチング その後研磨まで一貫処理されます。 表面研磨後のウエハーは客先ごとの詳細仕様に仕上げられた後世界各地の半導体製造工場に送られます。 いわば写真技術で言うところの露光前の印画紙に相当します。この基盤の上にいろいろな半導体集積回路が作り込まれてゆきます。 |
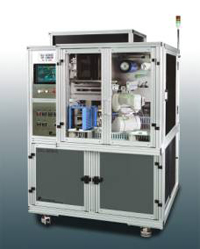 テイコクテーピングシステム(株)の DXL-800X全自動ラミネーター装置は インゴットから切り出されたウエハーの外形誤差や厚みの誤差。さらには傷、欠陥などの状態をCCDカメラによる 画像処理技術により全数検査及び 中央の集中制御コンピューターからのデーターをリアルタイムに計測して 弊社独自の知能型ロボットが適切にプロセスのレシピを柔軟に変更して実行してゆきます。 |
| このページのトップへ |
2: 材料としてのシリコンウエハーから半導体製品としてのシリコンウエハーに
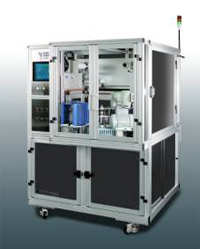 各半導体メーカーでは各社独自の製品プロセスにより多種多様な半導体製品が製造されます。 |
代表的な回路製造工程 各詳細の工程内容紹介
| エッチング 次世代に対応する高密度プラズマエッチング装置を使用しています。また量産性にすぐれる酸化膜エッチング装置も使用されます。 |
|
| イオン注入 前段加速方式を採用した幅広いエネルギーレンジと高い精密ドーピングを持つ新世代枚葉式イオン注入装置により従来の装置構成に比べ精密注入による歩留まりと工程の運用効率向上を実現します。 |
|
| 高温プロセス 均一な膜厚および比抵抗分布を持つ高品質のエピタキシャル層を効率的に形成できる高いプロセス性能とCOOの低減を実現した高速熱処理装置などを使用します。 |
|
| 絶縁膜CVD 信頼性の高い絶縁膜CVDチャンバを搭載した枚葉式マルチチャンバ絶縁膜CVD装置200mmウエハー対応チャンバ搭載を更に300mm対応へスケールアップさせた高密度プラズマ絶縁膜CVD装置またツインチャンバ方式を採用し最大6枚のウエハー処理が可能な最先端デバイス処理に要求される高度なプロセスを実現します。 |
|
| メタルCVD/PVD 先端デバイスのメタル配線プロセスを可能にするCVD/PVDメタルインテグレーション装置や、0.13μm以降の次世代ロジックやメモリーに対応するタングステン埋め込み性能を備えた枚葉式 マルチチャンバタングステンCVD装置、200mm/300mmウエハー双方に対応し、最新のCuフィルプロセスを行う銅配線電解めっき装置を使用し、時代のニーズに対応しています。 |
|
| CMP CMPシステムのメインフレームに独自の洗浄機を統合したドライイン-ドライアウトCMPシステムや、これをもとに、銅配線など最先端デバイス技術で必要とされる 優れた平坦化性能を兼ね備えたプロセスで多層化・微細化に対応する再現性の高いCMP工程をサポートします。 |
|
| 検査・測定 ウエハー表面欠陥検査装置や最新量産用の全自動CD-SEM装置のほか、全自動欠陥レビューSEM装置やパーティクルモニタリング装置を使用しています。 |
|
| このページのトップへ | |
3: さらなる高集積化
|
半導体集積回路が作り込まれたシリコンウエハーはその最終使用目的に適合するようさらに薄く小さくまたさらなる高集積化を目的として軽薄短小化を追求していきます。 特に今日要求の高い 非接触型ICカード(JR東日本のSUICA, ITSシステム用ETCカード、ICチップ内蔵型クレジットカードなど)、PDA、携帯電話、ノート型パソコン、 などの携帯端末機器ではシリコンウエハーを紙よりも薄くする技術が求められています。 また半導体産業は数多くの薬品や純水に代表される水を大量に消費いたしますが環境負荷を考慮したエコロジー指向の技術開発が愁眉の急でもあります。 テイコクテーピングシステムはその得意技術を活用してさらなる半導体製品の高集積化を進めて参ります。 |
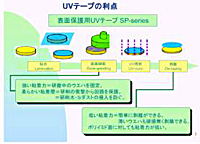 古川電工関連ページへ 集積回路が形成されたシリコンウエハーは大変に割れやすくなっています。シリコンウエハーは元々740ミクロン (8インチウエハーの場合)の厚みをもっていますが、それらのウエハーは非接触型ICカードとして利用するために80ミクロンまでのほとんど紙の厚さまで薄く研削されることになります。 ここでも 紫外線硬化型UVテープは集積回路の保護およびウエハーの割れ防止をかねて大変重要な役割をになっています。 また従前の保護方式のように回路面の保護に薬品を一切使用しないために洗浄の必要性が無く環境に対する負荷を限りなく小さくすることが出来ます。 |
テイコクテーピングシステム(株)のラミネーター
 CCDカメラによる画像認識処理により知能ロボットがウエハーの厚み誤差や外形寸法のバラツキを自動的に 吸収して高い生産性と歩留まりの向上を実現します。 この工程は裏面研削工程(バックグラインド工程)として知られています。 |
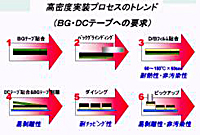 裏面研削(バックグラインド)の完了したウエハーはUVテープを UV照射して自動剥離された後
裏面研削(バックグラインド)の完了したウエハーはUVテープを UV照射して自動剥離された後シリコンチップとインターポーザーの間に接合されるダイボンドフィルムが貼り付けされます。 このあとチップを一つずつ切り離していくダイシング工程によって切りはなされます。 ダイシングに先だってウエハーの位置決めと飛散防止のための金属フレームへのマウント作業が行われます。 |
| このページのトップへ |
4: 新工法、新材料により実現される先進のパッケージ技術
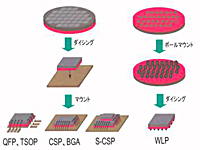 新材料 ダイボンドフィルムの採用により多種多彩でかつ高集積度の半導体パッケージが実現します。 新材料 ダイボンドフィルムの採用により多種多彩でかつ高集積度の半導体パッケージが実現します。また究極の実装形態といわれているWLP(ウエハーレベルパッケージ)もこのダイボンドフィルムの技術なしには実現できません。 |
 高精度位置決め装置とCCDカメラによるパターン認識技術によりシリコンウエハー上の集積回路パターンとボールマウント位置を高精度に位置決めしてWLPパッケージの製造の自動化を推進します。 |
| このページのトップへ |
5: UV照射技術と先進パッケージ技術
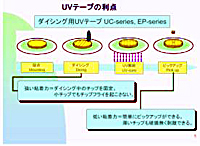 古川電工関連ページへ UVテープはシリコンウエハーから個別の半導体チップに加工するためになくてはならない技術になろうとしています。 薄くもろくなったシリコンウエハーをダイシング工程中にはしっかりと固定してピックアップの時にはシリコンチップに機械的ストレスをかけることなく剥離する、相反する条件を紫外線照射技術が実現します。 |
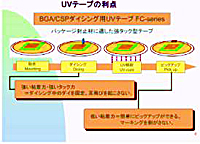 古川電工関連ページへ 新材料は新パッケージはその先進性及び高集積度特性により難加工材である場合がほとんどです。 この場合にもUVテープはなくてはならない技術になっています。 ダイシング工程中にはしっかりと固定してピックアップの時には機械的ストレスをかけることなく剥離する、相反する条件を紫外線照射技術が実現します。 |
 |
| テイコクテーピングシステム(株)はこれらの技術、製品をたゆまぬ創意と工夫と努力を基としてさらに進化させて高度情報化社会を支えていきます。 |
| NewProducts | 製品リストへ | このページのトップへ |
copyright (c) 2007 TEIKOKU TAPING SYSTEM CO.,LTD. All Rights Reserved
当サイトの画像の無断添付はご遠慮ください。著作権はテイコクテーピングシステム株式会社にあります。
お問い合わせはこちらから | TEL.0562-33-7172 FAX.0562-33-7173
当サイトの画像の無断添付はご遠慮ください。著作権はテイコクテーピングシステム株式会社にあります。
お問い合わせはこちらから | TEL.0562-33-7172 FAX.0562-33-7173